astratto
per l'applicazione di celle solari, la stabilità della qualità di passivazione dell'interfaccia alle condizioni sul campo è fondamentale. abbiamo eseguito un esperimento per testare la resilienza di diversi schemi di passivazione basati su ossido di alluminio per l'illuminazione a 75 ° c. diversi trattamenti termici per attivare la passivazione e / o simulare il fuoco di contatto sono stati eseguiti prima di ammollo luce. l'esperimento è stato eseguito su un silicio a zona galleggiante da 1 Ωcm di drogaggio di tipo p e n. lo studio dimostra che una buona qualità di passivazione può essere raggiunta sia con la deposizione dello strato atomico che con il pecvd e che l'aggiunta di strati di tappatura di nitruro di silicio migliora notevolmente la stabilità termica. su wafer di tipo p è stata osservata una degradazione grave ma temporanea della qualità elettrica della massa di wafer durante le prime ore dopo l'applicazione di tali strati di tappatura. oltre a questo effetto, è stata osservata una ragionevole stabilità temporale della durata effettiva per i campioni di tipo p, mentre i campioni di tipo n presentavano un'eccellente stabilità a lungo termine.
parole chiave: silicio di zona galleggiante, passivazione di ossido di alluminio, stabilità, ammollo leggero
1. Introduzione
I recenti miglioramenti dell'efficienza dei concetti di celle solari industrialmente fattibili sono stati guidati da
miglioramenti della qualità della massa del materiale e riduzione delle perdite di ricombinazione sulle superfici. questo è stato supportato
dall'emergere di schemi di passivazione basati sull'ossido di alluminio per applicazioni industriali a causa del loro bene
proprietà di passivazione. la buona qualità di passivazione degli strati di ossido di alluminio è ben stabilita in letteratura e
dimostrato da una moltitudine di studi, ad es. [1] e riferimenti in esso. studi riguardanti la stabilità di
gli schemi di passivazione di solito si concentrano su un sistema e / o su un fattore di stress come l'oscurità, l'illuminazione o l'umidità
condizioni di prova di calore [2-4]. per generalizzare i risultati precedenti abbiamo eseguito uno studio comparativo multiplo
schemi diversi a una combinazione di fattori di stress che si verifica durante il funzionamento del modulo fotovoltaico: illuminazione a
temperatura elevata.
nomenclatura
strati di ossido di alluminio stechiometrico al2o3 depositati da p-ald
strati di ossido di alluminio alox depositati da pecvd
fz float-zone
favorisca il degrado indotto dalla luce e da temperature elevate
deposizione di strati atomici attivati dal plasma p-ald
deposizione di vapore chimico potenziata con plasma di pecvd
imaging a fotoluminescenza pli
rtp rapido trattamento termico
velocità di ricombinazione superficiale srv
2. esperimento
2.1. preparazione del campione tutti gli esperimenti sono stati eseguiti su wafer di silicio a 4 pollici (fz). dopo la pulizia chimica a umido, è stato eseguito un trattamento di ossidazione a 1050 ° c per stabilizzare la qualità della massa del wafer, come suggerito da Grant et al. [5]. lo strato di ossido di silicio risultante è stato successivamente inciso. per dimostrare se il trattamento termico ha influenzato l'esperimento, un gruppo campione di riferimento non è stato sottoposto ad esso. gli strati di ossido di alluminio investigati di spessore di 20 o 30 nm sono stati depositati su entrambi i lati del wafer mediante deposizione di strato atomico plasma-attivato (p-ald) a 230 ° c o mediante deposizione di vapore chimico potenziata con plasma (pecvd) a 300 ° c. l'applicazione comune degli strati di ossido di alluminio in ambiente industriale è costituita da strati sottili ricoperti da ulteriori strati dielettrici. questi livelli di solito forniscono funzioni aggiuntive come miglioramenti ottici o una struttura semplificata. si è inoltre dimostrato che gli strati di nitruro di silicio depositato da pecvd si sono rivelati vantaggiosi per la stabilità degli strati di passivazione di ossido di alluminio ai trattamenti termici, ad es. [6, 7]. pertanto, per una parte dei gruppi campione 100 nm di a-sinx (indice di rifrazione 2) sono stati depositati in cima agli strati di ossido di alluminio. dopo la deposizione, gli strati di passivazione sono stati attivati da una varietà di trattamenti termici che somigliano a potenziali trattamenti nella lavorazione delle celle solari. i campioni sono stati ricotti nella formazione di gas a 425 ° c, in aria ambiente su una piastra riscaldante a 450 ° C o in atmosfera di azoto in un forno di lavorazione termica rapida (rtp) a 650-900 ° c. l'incertezza relativa alla temperatura effettiva del campione per quest'ultimo processo è stimata in un intervallo di tset ± 15 k dalle misurazioni della termocoppia.
una vasta gamma di schemi di passivazione e combinazioni di processi termici è stata studiata nello studio. una panoramica delle variazioni studiate è riportata in fig. 1.
2.2. le condizioni di prova e le misurazioni di caratterizzazione della durata effettiva del vettore di carica di minoranza τeff su campioni di vita simmetrici forniscono una misura per la ricombinazione nella massa di wafer e nelle interfacce alla passivazione superficiale. uno strumento sinton wct-120 è stato utilizzato per misurare τeff in una regione del diametro di 4 cm attorno alla metà del
campione. le vite sono state valutate a una densità di portatori di cariche fisse di minoranza di 5 × 1015 cm-3 per entrambi i tipi di doping.
l'attività di ricombinazione nel wafer e i cambiamenti della qualità della passivazione superficiale possono essere facilmente risolti a questo
il livello di iniezione e la misurazione nel centro del wafer riducono al minimo l'influenza dei danni dovuti alla manipolazione.
la stabilità degli schemi di passivazione studiati per l'illuminazione a temperatura elevata è stata eseguita da 1 sole
illuminazione equivalente della lampada alogena a 75 ° c. le misure di durata erano eseguite ex situ, cioè i campioni erano
rimosso dalla fase di campionamento a temperatura controllata.
temperature nell'ordine di 75 ° c possono verificarsi in funzionamento in campo con illuminazione intensa. come
le condizioni ovviamente non si applicano continuamente. tuttavia, ci aspettiamo che queste condizioni si accelerino e si intensifichino
possibili effetti di degradazione mentre, si spera, non si attivano effetti che non si verifichino nell'applicazione effettiva. esso
Va notato che l'illuminazione della lampada alogena usata mostrava una quota minore di lunghezze d'onda UV rispetto a quella solare
spettro. d'altra parte, questa parte dello spettro è spesso assorbita nel modulo convenzionale di vetro e cella solare
materiali di incapsulamento.
3. Risultati
3.1. qualità di passivazione
una panoramica dei migliori valori misurati di τeff dei gruppi campione introdotti in fig. 1 sono mostrati in fig. 2. il
misurato τeff sui campioni dimostra che i diversi schemi di passivazione e processi termici si traducono in
diversa qualità di passivazione. osserviamo che entrambe le tecniche di deposizione per l'ossido di alluminio possono fornire eccellenti risultati
passivazione quando uno strato di capping a sinx è depositato sopra. i campioni investigati dei gruppi 1 e 2 presentano τeff
valori vicini alla parametrizzazione del limite intrinseco di Richter et al. [8]. alcuni campioni di tipo N superano addirittura il
parametrizzazione, che indica un rendimento passivo eccezionale. alcuni dei campioni di tipo p sono leggermente
affetti da contaminazione da ferro introdotta durante la lavorazione chimico-umida, che causa una leggera diminuzione in
tutta la vita. oltre agli effetti indotti dal ferro, su alcuni campioni si osserva un miglioramento di τeff all'illuminazione
a 75 ° c, indicando un miglioramento dei parametri dell'interfaccia nel tempo. campioni che non sono stati sottoposti al
La fase di ossidazione di 1050 ° C (gruppo 3) mostra valori di τeff inferiori a quelli con la stessa passivazione di superficie dopo il
pretrattamento termico i campioni che non presentano uno strato di tappatura a sinx (gruppo 4) hanno una durata inferiore
livello, dimostrando la disponibilità di tali livelli.
3.2. attivazione di difetti alla rinfusa in silicio tipo fz di tipo p.
osserviamo che diversi campioni di tipo p dei gruppi da 1 a 3 (cioè dotati di uno strato limite) mostrano una degradazione
seguito da un recupero di τeff su illuminazione a 75 ° c nelle prime ore. un effetto simile è stato osservato da
sperber et al. [9] ed esempi sono mostrati in fig. 3. a seconda della temperatura di cottura, osserviamo il temporaneo
degrado per essere severo. i campioni sparati ad alte temperature mostrano una bassa durata di iniezione pari a 30 μs nel
curva minima, mentre i campioni sparati a temperature moderate mostrano solo una lieve degradazione. un modello caratteristico
è visto in imaging di fotoluminescenza e un trattamento di ri-passivazione della temperatura ambiente dimostra in modo conclusivo
l'effetto è causato da difetti attivi ricombinativi nella massa di wafer. un'indagine approfondita e discussione di
l'effetto può essere trovato in rif.
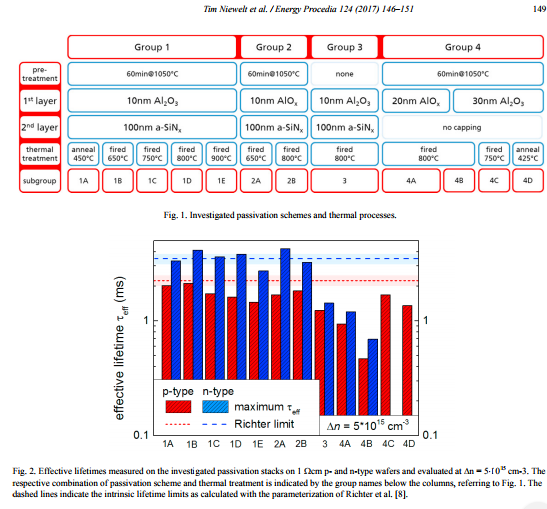
3.3. stabilità a lungo termine
le evoluzioni temporali di τeff misurate su campioni dei gruppi 1 e 2 sono mostrate in fig. 3. il tipo n
i campioni presentano un'eccellente stabilità durante l'esperimento. la progressione dei campioni di tipo p è
dominato dai difetti di massa discussi nella sezione 3.2 (e rif. [10]) nelle prime dieci-venti ore. in seguito,
le vite sono stabili ad un livello elevato per 1000 ore, seguite da un leggero degrado. i campioni passivati da
gli strati di ossido di alluminio nudo (gruppo 4) mostravano una leggera ma costante degradazione del τeff misurato (non mostrato).
tuttavia, l'imaging pl ha rivelato la degradazione originata da danni superficiali correlati alla manipolazione del campione
strati sottili. a causa del livello di vita complessivo più basso, non è possibile escludere l'effetto osservato sui campioni di tipo p ricoperti
per verificarsi su strati di ossido di alluminio nudo, ancora. le progressioni misurate di tutti i gruppi di campioni e una dettagliata
la discussione può essere trovata in rif.
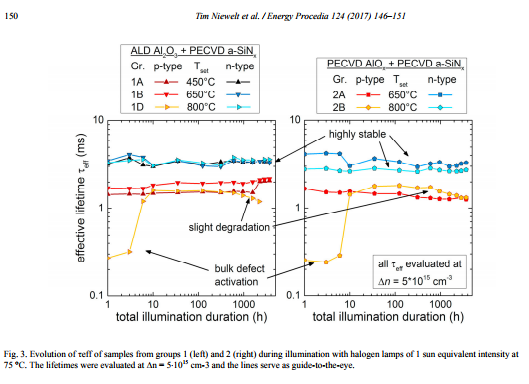
4. Conclusione
abbiamo eseguito un esperimento con una varietà di schemi di passivazione basati su ossido di alluminio depositati su wafer di silicio di tipo fz di tipo 1 Ωcm p- e n. sono stati sottoposti a diversi trattamenti di attivazione termica per studiare la qualità della passivazione risultante e la sua stabilità all'illuminazione a temperatura elevata. le vite effettive misurate dimostrano che gli strati di ossido di alluminio possono fornire una qualità di passivazione molto buona. le vite misurate su alcuni campioni di tipo N superano sistematicamente anche l'attuale parametrizzazione della ricombinazione intrinseca data da Richter et al. [8]. questo indica un'eccellente qualità di passivazione e suggerisce che la parametrizzazione sia troppo conservativa.
le prove di stabilità sono state eseguite mediante illuminazione alogena con un'intensità equivalente al sole a 75 ° c per diverse migliaia di ore. è stata osservata un'eccellente stabilità dei campioni di tipo N passivati dall'ossido di alluminio e protetti da uno strato di capping a sinx. I campioni di tipo p trattati allo stesso modo presentavano un degrado significativo ma temporaneo della durata della vita alla rinfusa e un leggero degrado per durate di illuminazione superiori a 1000 ore. le condizioni sperimentali (per lo più la costante alta temperatura) determinano una significativa accelerazione degli effetti rispetto all'applicazione sul campo. pertanto, i risultati simulano l'applicazione sul campo di diversi anni e quindi il degrado osservato non dovrebbe essere molto dannoso per il funzionamento del modulo. tuttavia, l'effetto dovrebbe essere tenuto presente per l'interpretazione degli studi eseguiti in tali condizioni, ad es. studi di letid o la stabilità dello stato di bo stabilizzato.
la stabilità a lungo termine degli schemi di passivazione investigati è discussa in dettaglio nel rif. [11]. il degrado è correlato alla formazione di difetti nella massa di wafer ed è il soggetto principale di ref.
riconoscimenti
questo lavoro è stato supportato dal ministero federale tedesco per gli affari economici e energia bmwi e dai partner industriali all'interno del cluster di ricerca solarlife con contratto n. 0325763a. gli autori sono responsabili per il contenuto.
fonte: ScienceDirect
per ulteriori informazioni, si prega di visitare il nostro sito: http://www.semiconductorwafers.net ,
mandaci una email a angel.ye@powerwaywafer.com o powerwaymaterial@gmail.com .